本記事では、空間的指標を用いた階層型クラスター分析を活用し、試行錯誤をしながらウェハーマップの欠陥パターンを分類した事例を紹介します。
下図のウェハーマップでは、各ダイ(チップ)の青色が正常、赤色が欠陥を示しています。
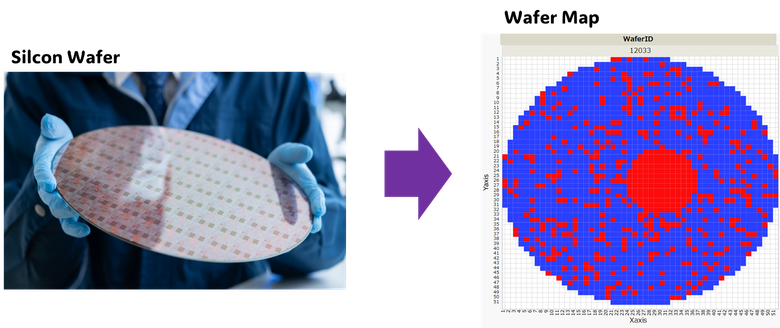
下図は9枚のウェハーマップにおける、欠陥パターンの分類例です。
Ring:円周上に欠陥が分布、Center:中心付近に欠陥が分布
Donut:ドーナツ状に欠陥が分布、Scratch:直線状に欠陥が分布
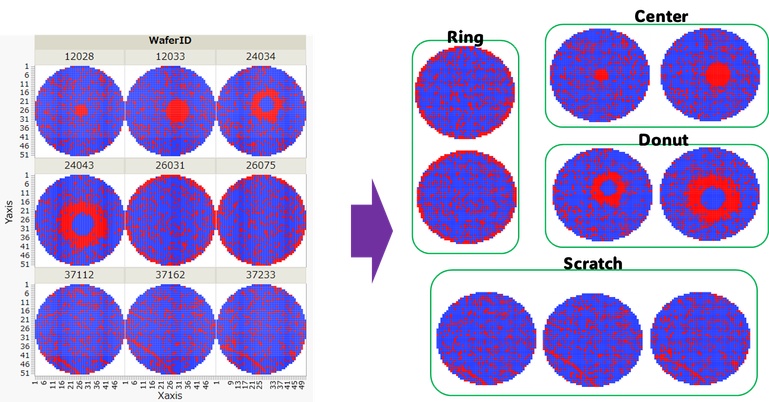
このような分類は、人間の感覚で行うことは可能ですが、大量のウェハーマップがある場合、クラスター分析を用いていくつかのパターンに自動的に分類することを検討します。
空間的指標を用いたクラスター分析
クラスター分析は多変量のデータをもとに、似た値をもつ行(この例では「ウェハー」)をいくつかのグループにまとめていく手法です。
ウェハーマップのようにXY座標で構成されているデータの場合、通常は下図のように1次元座標データに変換してクラスター分析を行います。
このデータでは、列名は(X座標 Y座標)を示し、正常を0、欠陥を1としています。例えば、列「1 21」は、各ウェハーにおけるX座標が1、Y座標が21の位置における正常・異常の値が入力されています。

ただし、1次元座標に変換すると、2次元座標がもつ空間的な位置関係が失われます。空間的な位置関係とは、近い点同士が隣接して欠陥が発生している場合や、特定の方向に欠陥が発生している場合などを指します。
そこで、JMPではこのような座標データに加え、以下のような空間的指標を含めてクラスター分析を行うことが可能です。

ウェハーマップの場合、同一半径上に欠陥が発生しているケースや、中心からの一定の角度において欠陥が発生しているケース、直線状に欠陥が並ぶケースがあります。このような場合、空間的指標も含めることで、欠陥パターンをより適切に分類できることが期待されます。
使用するウェハーマップデータ
以下のような7つの欠陥パターンのいずれかを持つ、332枚のウェハーマップのデータを用います。
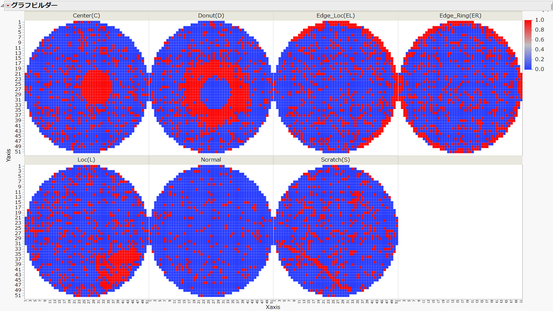
JMPによる空間的指標を考慮した階層型クラスター分析
JMPで空間的指標を含めた階層型クラスター分析を行うには、下図のように積み重ねた形式のデータを準備する必要があります。各ウェハーについて、Y座標、X座標、Defect(その座標において正常であれば0、欠陥があれば1の値をとる)で構成されています。そのため、各ウェハーに対して座標の数(この例では2061)だけデータ行があります。

「空間的指標の計算」にチェックをいれると、1次元座標の情報(属性)に加えて、空間的指標(扇形の角度、円の半径、筋の角度、筋の位置)を変数としてクラスター分析を実行できます。

クラスター数を20個に設定し、「クラスターの要約」のオプションを実行したときの結果を以下に示します。

「クラスターの要約」により、20個のクラスターごとのウェハーマップのパターンを確認できます。この結果から、Center、Donut、Loc、Edge_Ring、Normal といった形状をさらに細かく分類できていることがわかります。
ただし、この時点ではScratchの欠陥パターンが検出されていないこともわかります。
Scratchを検出するために
そこで、空間的指標の意味をJMPのヘルプで確認してみます。
| 扇形の角度 |
扇形や半球形に分布していることを示す指標です。 |
| 円の半径 |
円状(ドーナッツ状)に分布していることを示す指標です。 |
| 筋の角度 |
同じ角度である筋(直線)を表す指標です。 |
| 筋の位置 |
同じ距離である筋(直線)を表す指標です。 |
JMPヘルプより
Scratchとは、ウェハーの製造工程で生じる細長い線状の傷を指します。この線状のパターンを検出するには、「筋の角度」や「筋の位置」が関係してそうです。
そこで、筋の角度や筋の位置の重みを非常に大きな値(=1000)に設定してクラスタリングした結果を示します。
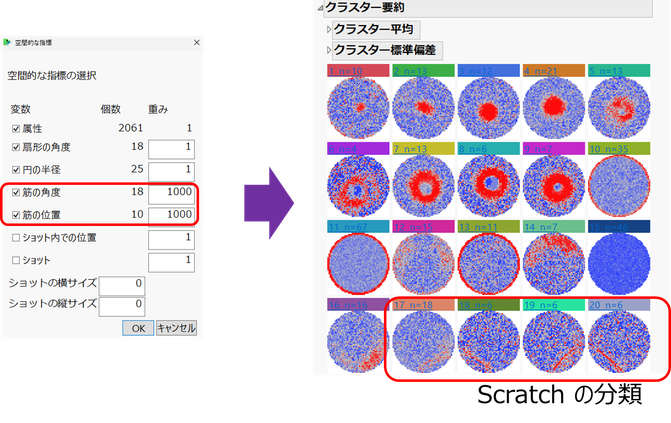
ようやくScratchの形状を確認できました。この例では直線を検出しやすくするために関連する指標の重みを大きくしましたが、CenterやDonutなど他の欠陥パターンを適切に検出できています。
クラスタリング結果まとめ
以下の図は、重みを調整して分類したときの結果です。縦軸が実際の欠陥パターン(ラベル)、横軸がクラスター分析で分類された20個のクラスターを示しています。各座標の黒い点の集まりは、度数の大きさを表します。

この結果から、概ね欠陥パターンをうまく分類できていることがわかります。
参考:Hough変換について
空間的指標である「筋の角度」、「筋の位置」は、Hough変換という空間上の直線を検出する手法と関連しています。
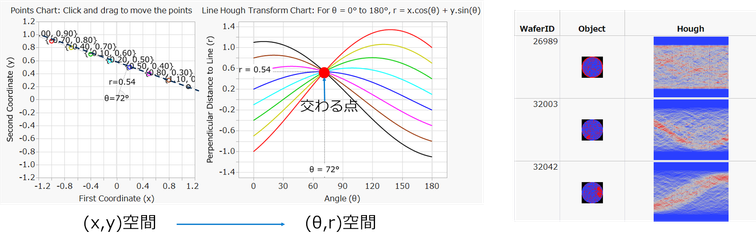
Hough変換では、2次元の座標(x,y)を変換式 r = x cos(θ) + y sin(θ) を用いて、(θ, r) 空間に変換をします。このとき、(x,y)空間において複数の点が同じ直線上にある場合、(θ,r)空間上では曲線が交わる点ができます。この性質を利用し、直線上に並ぶ点の集まりを検出する仕組みです。
この考え方をインタラクティブに理解できるJMPアドインも公開されています。
データの出典
GitHub - Junliangwangdhu/WaferMap
JMPアドイン:Hough変換のデモ
Line Hough Transform Demo - JMP User Community
参考論文:Hough変換を半導体ウェハーの欠陥分類に適用
White, K. P., Jr., Kundu, B., and Mastrangelo, C. M. (2008). “Classification of Defect Clusters on Semiconductor Wafers Via the Hough Transform.” IEEE Transactions on Semiconductor Manufacturing 21:272–278.
by 増川 直裕(JMP Japan)
Naohiro Masukawa - JMP User Community
You must be a registered user to add a comment. If you've already registered, sign in. Otherwise, register and sign in.